近几年,中国半导体产业继续维持高速增长态势,增长率超过了20%;IC设计、封测、晶圆制造以及功率器件是为4大推动主力。其中,封测行业在过去十多年中,因成本比较高,主要靠量推动发展,并是过去我国半导体产业4大推动力中产值最高的一块。不过,近两年来,我国的IC设计行业获得了巨大发展,2018年其产业营收已经超过了2500亿人民币规模,超过了封测产业的产值,未来还将继续高速发展。由此,封测行业也将继续成长,以匹配正在高速发展的IC设计行业发展需求。

从行业发展历程来看,包括封测行业在内的半导体产业主要由几类代表性产品所驱动。在上世纪80年代中期,由计算机主机和台式电脑推动发展;这一时期,笔记本电脑的发展势头也开始慢慢展现。而到了上世纪90年代中期,笔记本电脑就成为了整个半导体产业的驱动主力。待进入千禧之年,以手机为代表的移动通讯产品开始引领半导体产业的高速成长。在2010年之后,集各种功能于一体的智能手机取代了上一代产品并高速成长,并成为当下半导体产业发展的驱动代表。封测行业正是伴随这些时代的产品升级而获得了巨大发展。

下一个驱动半导体产业继续繁荣的代表产品又是什么呢?目前主流观点认为,数据运算时代将会成为当下的驱动主力,这是因为在端对端的应用中,如手机平台、汽车平台、智能制造、智能家居等,将会构建边缘云计算的庞大网络,形成端应用,这就需要庞大的大数据运算能力,离不开5G、AI、云计算等技术的支撑。面对新的产业变化,封测行业该如何应对?需要哪些新的技术来匹配发展?云端应用需要非常宽的带宽,我们知道,摩尔定律及先进制程一直在推动半导体行业的发展,封装行业也需要新的技术来支持新的封装需求,如高性能2.5D/3D封装技术、晶圆级封装技术、高密度SiP系统级封装技术、高速5G通讯技术以及内存封装技术等,这些将会成为接下来封装行业跟进产业潮流的主流技术及方向。2.5D/3D先进封装集成目前,需要从FcBGA等平台上提供最大的封装尺寸,从传统的2.5D封装提供转接板工艺开始,深入开发及提供低成本方案,比如长电科技的UFOs基板技术,既可以替代原来的基板,也可以在基板中增加一层薄膜,还可以作为高密度的封装方案,从而降低封装的成本,并提高产品的性价比。
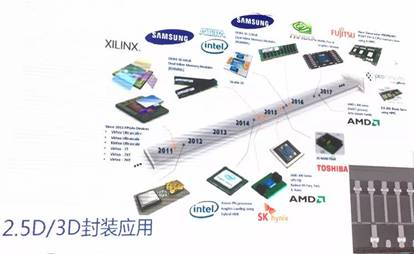
晶圆级封装技术晶圆级封装技术应用非常广泛,成长也非常迅速,目前可以做到8英寸、12英寸多层封装。该技术还可以用来实现Remain封装,可以很好地提高产品的可靠性。其中,Fan-Out技术是当下晶圆级封装技术中的热门,这需要利用晶圆级平台来实现,星科金鹏推出的eWLB正是Fan-Out技术方案之一,DECA和近几年台积电采用的InFo也是行业重要的晶圆级Fan-Out封装方案。eWLB和FO-ECP是长电科技目前施行的主要方案,其中eWLB属于通用级技术,使用领域广泛;而FO-ECP为长电科技专门开发的新技术,能对封装体提供支持,侧重于尺寸比较小的产品的封装,主要面对消费级、功率器件领域产品。当然,利用Fan-Out方案也可以为高密度芯片互联结构设计提供支持,这是一种偏向于芯片工艺的封装技术,可在晶圆层面实现局部优化,通过互联技术,将不同的芯片结合在一起。 
系统级封装集成SiP

系统级封装是目前各封装企业着力发展的重要技术,其驱动力主要来自两个方面,一是摩尔定律迈向收官阶段,行业的发展越来越困难;值得庆幸的是,目前有消息称,基于硅基技术,摩尔定律有望延后到2040年才会终结,当然,越往后,每一次技术进步所付出的成本会越来越高。另一方面就是通过系统级封装集成技术来实现更为精密的生产制造,从而可以推出不同的器件、不同功能的元件,如2D、3D、多层叠加等技术,将现有的技术运用起来,形成封装系统集成。目前苹果产品在系统级封装领域已经走在了行业前列,其手机产品中采用到系统级封装的元器件几乎占到了整个产品的一半,剩下的一半为晶圆级封装。模块化产品设计已经成为苹果公司的标配;他的这一动作,为封装行业的发展指明了道路,也影响了行业的产品设计走向,目前三星、华为、索尼、小米等企业也在慢慢往系统级封装领域靠拢。
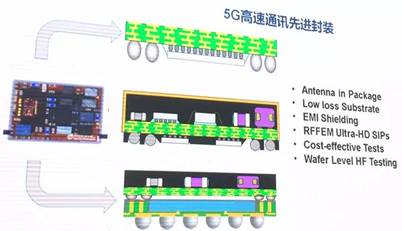
系统级封装技术可以解决目前我们遇到的很多问题,其优势也是越来越明显,如产品设计的小型化、功能丰富化、产品可靠性等,产品制造也越来越极致,尤为重要的是,提高了生产效率,并大幅降低了生产成本。未来,系统级封装将在小型化、高密度封装、散热方面发挥越来越重要的作用。当然,难点也是存在的,系统级封装的实现,需要各节点所有技术,而不是某一技术所能实现的,这对封装企业来说,就需要有足够的封装技术积累及可靠的封装平台支撑,如高密度模组技术、晶圆级封装技术等。而且,针对不同产品,封装技术也不同,如手机的RF模块,其上集成了不同的芯片、不同的元器件等,每一种元件对封装的要求都不一样,这就要求封装企业要有足够的技术和经验来应对。 5G高速通信封装当下,与系统级封装技术紧密相连的应用正是5G通信。5G的标准有三大块:5G毫米波、6GHz的5G技术、5G IOT,它们都要求端对端高速连接,进而要求产品要具备较高的频率,当然也会造成因波长变短而衍生的新问题,如5G手机的噪声将会变大,这只能通过将天线与手机芯片直接集成来解决,这本质上就是系统级封装在特定领域的应用。正因为5G时代即将到来,封装企业针对5G封装技术的开发,正处于激烈的竞争阶段。目前不同的企业,其封装技术也不一样,如陶瓷晶圆级技术方案等。在5G封装应用中,电磁辐射的影响也亟需解决。5G产品的MIMO有很多不同的元件需要同步工作,这会造成严重的电磁干扰,电磁屏蔽无可避免。目前行业主要提供有腔体屏蔽、半屏蔽以及全屏蔽三种方案。

内存封装内存需求依然火爆,目前半导体行业实现的增长中,绝大部分与内存有关,因此,封装企业也非常关注内存领域产品的封装。从技术角度看,目前存储封装主要是堆叠技术,但随着要求越来越高,Flip Chip、TSV等封装技术将会被越来越多地应用到内存封装上来,包括晶圆级封装Fan-Out方案。除了专门的内存封测企业,长电科技等通用的封测企业也会越来越多涉及内存封测,堆叠超薄、隐形切割等技术也将会更多地得到应用。由于摩尔定律走向困难期,存储封装更多地引入了3D封装技术,有效解决了2D技术中不大容易被解决的问题,通过该技术,目前已经成功封测出了存储空间高达1TB的内存产品。
注:本文内容来自江苏长电科技高级副总裁梁新夫先生在2018年IC设计年会的演讲,芯师爷对其内容做了部分编辑,感谢梁新夫先生。







